この記事には広告を含む場合があります。
記事内で紹介する商品を購入することで、当サイトに売り上げの一部が還元されることがあります。
半導体(IC)パッケージは、半導体チップを外部環境から保護や放熱、電気的に外部回路と接続する役割を担っています。電子機器の進化に伴い、パッケージ技術も小型化・高密度化・高性能化が求められています。
本記事では、半導体パッケージの概要、主な役割、そして代表的な種類について分かりやすく解説します。
目次 非表示

半導体パッケージは、製造された半導体チップを保護し、基板やその他の回路に接続するためのケースのことです。
プラスチックやセラミック、金属といった素材でできており、下面や側面に接続用の金属端子(リード)が配置されています。プリント基板上のソケットに差し込んだり、はんだ付けすることで実装します。
主に、以下のような役割を担っています。
- 物理的保護:チップを外部環境(湿気、衝撃、熱など)から保護します。
- 電気的接続:チップと外部回路を電気的に接続します。
- 熱管理:デバイスが発生する熱を放散し、過熱を防ぎます。
半導体パッケージは、デバイスとプリント基板との接続の仕方により、大きく「挿入実装型」と「表面実装型」に分類されます。
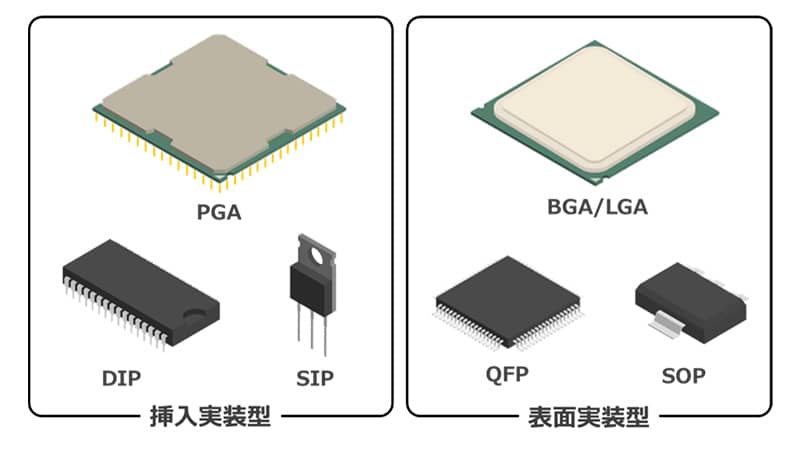
挿入実装型
プリント基板にリードを貫通させるように挿入するタイプのパッケージです。代表的な挿入実装型のパッケージは、次のようなものがあります。
- SIP (Single Inline Package):リードがパッケージの1側面から出ており、リードが1列に並んでいる構造です。パッケージの側面に放熱板を取り付けられます。小規模なICに使用されてます。
- ZIP (Zigzag Inline Package):リードがパッケージの1側面から交互にジグザグ状に並んでいる構造です。SIPよりも同じリード数でコンパクトにできます。
- DIP (Dual Inline Package):長方形のパッケージで、リードが2側面から出ている構造です。アナログICや小規模デジタルICに使用されています。
- PGA (Pin Grid Array):ピンがパッケージの底面に格子状に配列されたパッケージです。パッケージ側面から端子を出す形状に比べて多くの接続端子が配置できます。
表面実装型
プリント基板の表面の電極パッドにリードを接触させ、固定するタイプのパッケージです。代表的な表面実装型のパッケージは、次のようなものがあります。
- SOP (Small Outline Package):リードがパッケージの2側面から出ており、リード形状がガルウィング型の構造です。
- SOJ (Small Outline J-leaded package):リードがパッケージの2側面から出ており、リード形状がJ字形の構造です。SOPよりもリードが変形しにくく、実装面積が小さくできる利点があります。
- QFP (Quad Flat Package):リードがパッケージの4側面から出ており、リード形状がガルウィング型の構造です。
- QFJ (Quad Flat J-leaded package):リードがパッケージの4側面から出ており、リード形状がJ字形の構造です。QFJよりもリードが変形しにくく、実装面積が小さくできる利点があります。
- LCC (Leadless Chip Carrier):底面の4辺に電極パッドを配置した構造です。
- BGA (Ball Grid Array):ボール状のはんだ(はんだボール)がパッケージの底面に格子状に配列された構造です。小型・高密度化が可能で、放熱性が高いです。高性能プロセッサやGPUに使用されます。
- LGA (Land Grid Array):ランドがパッケージの底面に格子状に配列された構造です。BGAと異なり、ソケットによる実装が可能です。
半導体パッケージは、デバイスの性能を最大化しつつ、信頼性を高める重要な役割を果たしています。パッケージの種類は、用途や性能に応じて選択されます。
様々な種類があり、名称と形状を一致させて覚えるのは難しいとは思いますが、代表的なパッケージは覚えておいてもいいと思います。
- 浅田邦博、パワーデバイス・イネーブリング協会「はかる✕わかる半導体 入門編 改訂版」、日経BPコンサルティング(2020/12/14)
- 京セラ「半導体(IC)パッケージとは」

